SPTS uetch vapor etch (uetch)
Overview
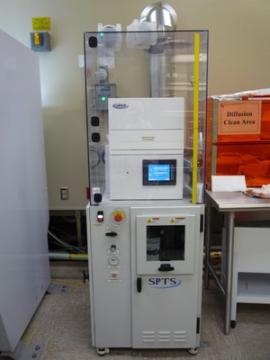
The SPTS uetch vapor system uses anhydrous HF and ethanol at reduced pressure and 45C to etch isotropically sacrificial silicon oxide layers, primarily to release silicon microstructures in MEMS devices. The dry process avoids stiction of released moving parts and damage to delicate structures – common issues with conventional wet processing technology. This is a single wafer system for 4 inch to 8 inch wafers and dies on a carrier wafer.
Cleanliness:
Processing Technique(s)
Capabilities and Specifications
Primary Materials Etched
Gases
Substrate Type
Substrate Sizes
Maximum Load:
1
Notes:
Pieces need a carrier wafer; Isotropic Etching
Lab Organization, Location, and NEMO Information
Lab Organization:
Location:
NEMO Area:
SNF: Dry Etching
NEMO ID:
uetch
Training and Maintenance
Lab Facility:
Training Charges:
0.50 hours
Primary Trainer:
Backup Trainer(s):
Primary Maintenance:
Backup Maintenance:
Steps to become a tool user
-
Become a member of SNF.
- Study the relevant operating procedures:
- Shadowing is required. Contact a qualified lab member of the tool to arrange to ‘shadow’. It would be best to find someone who has used the system often. If you don’t know of anyone, you may check reservations or history to find a qualified user. We recommend that you be with the lab member for the full time while operating the tool and ask lots of questions during the shadowing. You may have to shadow a qualified user more than one time to be comfortable with the tool. Please follow the instructions on this form: Shadowing at SNF
- Contact the primary trainer: Uli Thumser


